Schnelle Prototypenfertigung von elektronischen Baugruppen
Leiterplatten
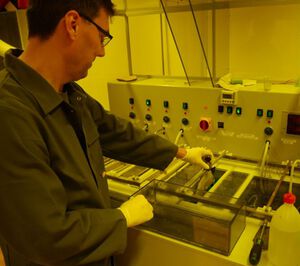
Wir stellen Multilayer Leiterplatten sowohl für unser Entwicklungsteam als auch in kleineren Stückzahlen auf Kundenanfrage in unserem eigenen Leiterplattenlabor selber in professioneller Qualität her.
=> Eine Schaltungsmodifikation inkl. Änderung des Leiterplattenlayouts und Produktion einer neuen Leiterplattenversion ist für unsere Ingenieure so nur noch eine Sache von wenigen Stunden.
Gerade diese Schnelligkeit verschafft uns und unseren Kunden einen wichtigen Wettbewerbsvorteil.
Verfügbare PCB-Substrate umfassen sowohl FR4 als auch HF-Materialien (z.B.: Panasonic, Rogers). Auch flexible Leiterplatten können wir für Sie fertigen.
Mechanische Arbeiten

In unserem Prototypenlabor verfügen wir über eine eigene CNC-Fräs- und Bohrmaschine und können daher auch mechanische Arbeiten kurzfristig durchführen.
Gefräst werden können neben PCBs auch Plastikteile sowie dünne Metallbleche.
Ferner besteht die Möglichkeit, durch Feinätzen von Kupferblechen Muster von Teilen herzustellen, welche später als Stanz-Biegeteil produziert werden sollen.
Manuelle Leiterplattenbestückung

In unserem Prototypenproduktionsprozess kann die Bestückung der Leiterplatten manuell oder für größere Stückzahlen oder auch Kleinserien mit Hilfe von Bestückautomaten durchgeführt werden.
Für kleine Stückzahlen und bei einer geringen Anzahl zu bestückender Bauelemente bietet sich manchmal die Handbestückung an. Unter dem Mikroskop werden die Bauteile platziert und mittels Handlöten mit der Platine verbunden.
Lötstationen von JBC und Weller in unterschiedlicher Leistungsfähigkeit mit für den jeweiligen Einsatzzweck von Größe und Form passenden Lötspitzen erlauben das Bauteil- und Leiterplatten-schonende Auflöten der Komponenten.
Alternativ wird bei großen thermischen Massen der Bauelemente Lötpaste aufgetragen, die Bauteile werden platziert und das Aufschmelzen des Lots erfolgt entweder in einem Reflowofen oder in der Dampfphasenlötanlage. Insbesondere beim Dampfphasenlöten erfolgt ein kontinuierliches und gleichmässiges Erhitzen der kompletten Baugruppe, ohne dass hierbei die zulässige Temperatur der Bauteile überschritten wird.
An Lötzinn verwenden wir von Almit Rollen mit hochwertigem, bleifreiem Lötdraht verschiedenen Durchmessers und unterschiedlicher Schmelztemperatur sowie Lotpasten unterschiedlicher Körnung.
Als Bauteile sind bei uns Widerstände, Kondensatoren und Spulen in den heute gebräuchlichsten SMD-Bauformen 0201, 0402 und 0603 eng toleriert standardmäßig verfügbar. Bei Bedarf an speziellen Bauteilen (ICs und passiv) übernehmen wir gerne die Beschaffung der Komponenten für Sie.
In der Regel wird die Bestückung allerdings mit dem hauseigenen Bestückautomaten durchgeführt.
Chipbonden

Zum Verbinden von ungehäusten ICs mit der Leiterplatte haben wir einen halbbautomatischen Die-Bonder und einen halbautomatischen Wirebonder im Haus.
Beim Wedge-Wedge-Bonden kann mit dem Wirebonder (HB16 von der Fa. TPT) eine Verbindung zwischen den Anschlusspads auf dem IC und den Gegenstücken auf dem PCB hergestellt werden. Als Alternative kann mit Golddraht auch Ball-Wedge gebondet werden. Die minimale Padgröße auf dem IC liegt hierfür bei ca. 65µm x 65µm, wobei der Mittenabstand zwischen benachbarten Pads mindestens 120µm betragen sollte. Die wichtigsten Kenndaten für das Drahtbonden bei uns sind:
- Ball-Wedge-Bonden mit Golddraht: Drahtdicke 17um bis 75um
- Wedge-Wedge-Bonden mit Gold- und Aluminiumdraht: Drahtdicke 17um bis 75um
- Bändchenbonden: max. 25um x 250um
Für das Aufkleben der Dies und das bei Bedarf dem Drahtbonden anschliessende Versiegeln des gebondeten ICs (Glob Top) wird der Die-Bonder HB75 von TPT benutzt. Mit diesem Bonder wird über einen passenden Stempel der Kleber für den IC auf das PCB aufgetragen und anschliessend mit einer Vakuumpinzette das IC präzise und reproduzierbar auf den Klebebereich aufgesetzt.
Für das Aufbringen des Glob Tops im Anschluss an das Drahtbonden haben wir Zugriff auf verschiedene 2-Komponenten Epoxide. Das Aufbringen des Epoxids wird mit einem am Halter des Bondarms angebrachten Dispenser vorgenommen. Die Zuteilung der zugeführten Epoxidmenge erfolgt hierbei reproduzierbar über die Regelung des Arbeitsdruckes und der Ventilöffnungszeit an der Dispensereinheit.
Das Aushärten des Klebers bzw. der Glob Tops erfolgt in einem temperaturgeregelten Ofen, bei dem verschiedene Temperaturprofile für das Aushärten programmiert werden können.

